半導體與液晶元件的高密度化正以驚人的速度推進。為了在更短時間內加工出更微細的線路圖形,高解析度且高感度的光阻材料(光聚合物、Photo Polymer/Resist)的開發至關重要。
具體而言,目前正從化學結構與製程兩個面向,著手開發用於 EUV(極紫外線)與 i線曝光 的化學增幅型三成分光阻材料(由基礎樹脂、溶解抑制劑與產酸劑所組成)。
講師曾任職於日本半導體設備製造商(現已退職),參與 64M DRAM 用化學增幅型光阻材料與製程技術 的開發工作。
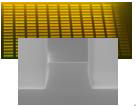
圖:新型微影技術的開發
本研討會將從半導體光阻技術的基礎開始解說,特別針對光阻材料(感光性樹脂)與製程、酚醛樹脂(Novolak)系正型光阻,以及化學放大型三成分(基材樹脂、溶解抑制劑、產酸劑)正型光阻,逐一說明其化學組成與光阻特性之間的關聯。
在半導體、LCD 等電子裝置的製造中,透過反覆進行成膜、圖案形成(光阻塗佈、曝光、顯影)、蝕刻、光阻剝離、清洗等流程,可在基板上形成具有微細構造的電晶體。這些流程統稱為微影(光刻)製程,通常需要重複約 20 至 30 次。本次演講將特別針對光阻材料(感光性樹脂)與製程進行說明,同時深入解析酚醛樹脂系正型光阻以及化學放大型三成分(基材樹脂、溶解抑制劑、產酸劑)正型光阻的化學構成與光阻特性之間的關係。
此外,也將以講者作為前半導體裝置製造商的視角,詳細說明光阻原料供應商(材料廠)在評估光阻時所採用的具體測試方法。
一、感光性光阻的基礎與微影工程解說
1-1 什麼是感光性光阻?
1-2 關於微影(光刻)技術
1-3 光阻的塗佈、曝光、曝光後烘烤(PEB)、顯影製程概要
二、光阻設計的演進與作用機制
2-1 半導體/電子裝置的演進與光阻設計的變遷
2-2 光阻的基本原理
2-3 光阻的顯影特性
三、酚醛樹脂(Novolak)系正型光阻的材料設計
3-1 使用光阻顯影分析儀(RDA)進行顯影特性評估
3-2 酚醛系正型光阻的分子量與光阻特性之關係
3-3 改變酚醛系正型光阻的前烘(Pre-bake)溫度進行特性評估
3-4 變更 PAC(光致鹼溶解抑制劑)酯化率對光阻特性的影響
3-5 顯影溫度與酚醛系正型光阻特性之間的關係
四、化學放大型正型光阻的材料設計
4-1 化學放大型三成分光阻的基材樹脂與光阻特性
.基材樹脂
.溶解抑制劑
.產酸劑
4-2 化學放大型三成分光阻的溶解抑制劑與光阻特性
4-3 化學放大型三成分光阻的產酸劑與光阻特性
4-4 向 EUV 光阻的技術延伸
4-5 向 i 線厚膜光阻的技術延伸
三建可為企業規劃專屬內訓課程,含客製化大綱、講師派遣與教材配套。