CMP(Chemical Mechanical Polishing,化學機械研磨)不僅是半導體製程中的一個步驟,更是決定先進技術可行性、晶片效能與供應鏈議價能力的關鍵節點,對企業的成長性和獲利能力有深遠影響。CMP是一項結合化學反應與物理研磨的平坦化技術,為半導體前段製程中不可或缺的關鍵製程之一。其主要目的在於去除多層結構所造成的表面不平整,使晶圓表面達到高度平坦,確保後續微影與配線製程能穩定進行。
CMP 製程主要由三個要素所構成
Chemical(化學作用):利用酸、鹼、氧化劑等化學藥液,促使材料表面發生化學反應
Mechanical(物理作用):透過研磨材,如 SiO₂、Al₂O₃、CeO₂ 等砥粒進行物理研磨
Planarization(平坦化):結合化學與機械作用,實現晶圓表面的整體平坦化
在研磨過程中,晶圓表面會產生削屑、殘留砥粒,以及金屬或有機污染物,因此在 CMP 完成後,必須搭配後續洗淨製程以確保表面清潔。對於邏輯積體電路(Logic IC)而言,表面平坦度直接影響微影製程的曝光與對焦精度。若積層結構不夠平坦,將導致圖案轉印失敗,進而影響元件效能與製程良率。因此,CMP 技術可說是多層結構晶片製造的基礎。
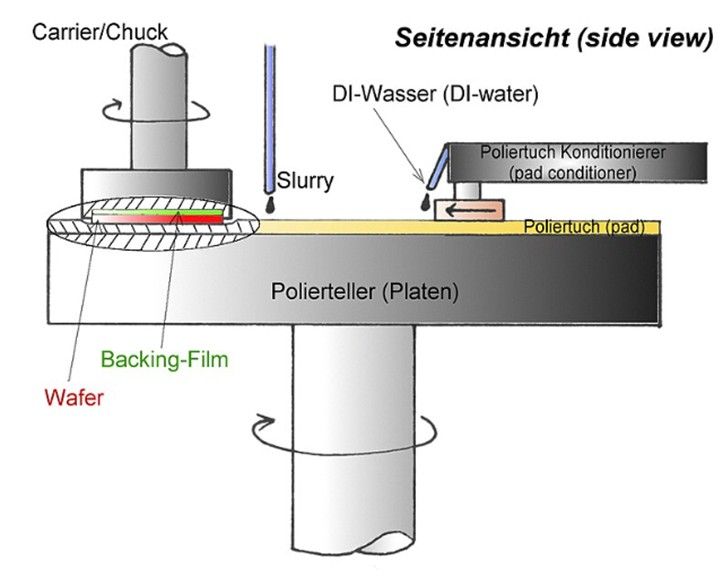
圖:CMP研磨側面圖(經濟部產業技術司網站/資料來源:wisem(2005))
目前多數 CMP 設備已將研磨與後續洗淨整合於同一系統中,以不同模組依序完成製程。後續洗淨設計上兼顧物理與化學作用,在有效去除污染物的同時,避免過度施加物理力,以降低晶圓表面刮傷或缺陷風險。
CMP 屬於半導體前段製程的一環,針對不同研磨對象層,需開發相對應的專用洗淨藥液。一般 CMP 後續洗淨液多由螯合(錯化)劑、界面活性劑、還原劑及 pH 調整劑等組成,為成分相對單純、金屬離子與不溶性微粒含量極低的水溶液,產品通常以 200 公升或 20 公升容器形式供應。
CMP 製程的應用層別涵蓋 STI/ILD(SiOx 膜)、鎢塞(W Plug)、銅配線,以及 Cu/Co Liner 配線等。隨著製程微縮與新材料導入,CMP 後續洗淨技術正朝向更低缺陷、更低材料耗損,以及更高材料相容性的方向發展。同時,因應環境、健康與永續(EHS)的要求,針對 TMAH 及其相關化合物的替代與減量,也成為洗淨藥液開發的重要課題。

