隨著半導體封裝技術、高頻通訊電路與可撓式顯示器的快速發展,傳統絕緣材料在熱膨脹、尺寸安定性以及加工性上逐漸暴露出限制。東洋紡株式會社(TOYOBO)及東洋紡MC株式會社服務的前田鄉司,在課程中介紹了聚醯亞胺薄膜基板材料的製程,以及高耐熱聚醯亞胺薄膜XENOMAX®的特性,並分享了其在先進電子封裝、高頻電路以及可彎曲顯示器製程中的應用潛力。
聚醯亞胺薄膜基板材料的製程
聚醯亞胺薄膜(Polyimide,簡稱PI)依製作方法不同,可分為溶融製膜(或二軸延伸法)與溶液製膜法。不同的製程會影響高分子鏈的排列與薄膜均質性,進而決定材料的熱穩定性、彈性模數以及表面平滑度。
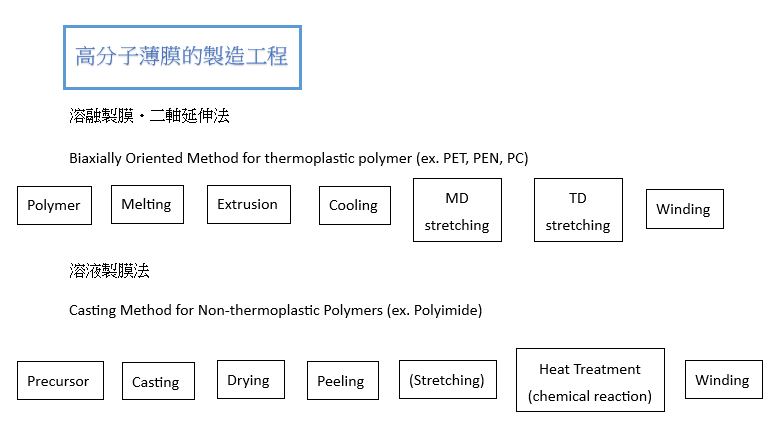
高耐熱聚醯亞胺薄膜 XENOMAX®
前田鄉司指出,XENOMAX®在廣泛溫度範圍內保持極低的熱膨脹係數(CTE),約為 3 ppm/K,接近矽晶片的水平。與傳統PI-A、PI-B相比,其加熱變形和熱收縮率明顯降低,而且薄膜正反面熱收縮率差異極小,因此製程中翹曲現象得到有效抑制。
他進一步說明,XENOMAX®的低CTE可透過吊墜模型(Pendant Model) 來理解:當溫度上升時,直鏈高分子沿鏈方向產生微縮,抵消體積膨脹,從而維持整體低膨脹的特性。此外,XENOMAX® 的彈性模數隨溫度上升下降幅度非常小,在約 330°C附近仍無明顯轉移點,表現出高溫下穩定的機械性能。
XENOMAX® 已通過美國 UL 認證,是全球最薄的無鹵阻燃薄膜。一般聚醯亞胺薄膜中會添加潤滑劑微粒以提升滑動性,但這些微粒會在薄膜表面形成微細突起,影響表面平滑度。XENOMAX® 不使用潤滑劑,因此表面極為平整,非常適合 TFT 與微型顯示器等高精度製程。

圖:XENOMAX®(TOYOBO)
在半導體高密度封裝領域,CTE不匹配是主要挑戰。傳統的有機/無機複合雖能降低 CTE,但加工性下降、絕緣層不均質,以及材料間應力集中等問題仍然存在。前田鄉司表示,使用 XENOMAX® 作為基板核心層材料,可將基板 CTE 從約 17 ppm/K 降至 3 ppm/K,與晶片匹配。堆疊層亦可採用 XENOMAX®,厚度可達 2 毫米,不僅強度高、彈性模數佳,且易於雷射或機械加工,顯著改善封裝製程的可靠性與可操作性。
在高頻電路基板中,微帶線結構上下兩面的導體覆蓋率不對稱,如果絕緣層 CTE 與銅箔不匹配,冷卻後會產生翹曲,影響信號傳輸。鐵氟龍(PTFE)因具優異電氣特性而被廣泛使用,但其高 CTE 導致冷卻後變形明顯。前田鄉司認為,氟樹脂與 XENOMAX® 局部複合可有效降低翹曲,同時保持高頻電氣特性與低介電常數與損耗。XENOMAX® 可耐 400°C,加工穩定,並可與 PTFE 貼合,達到上下兩面導體的熱膨脹匹配。
在可彎曲顯示器製程中,透過表面化學鍵結使 XENOMAX® 薄膜在無需接著劑的情況下完成高溫貼合與脫離,可應用於 Mini LED 顯示器、電子紙以及無芯基板製程,並具有延伸到高密度封裝製造的潛力。

