隨著人工智慧、高速運算與5G通訊的快速發展,半導體產業對先進封裝基板的需求急速攀升,尤其是採用ABF(Build-up Film)材料製造的載板設備正面臨供不應求的挑戰。這反映出ABF技術在推動晶片小型化、高密度化上的關鍵地位。本文聚焦於ABF材料的誕生、技術演進及其對半導體封裝產業的影響。
味之素跨足半導體材料的歷史背景
日本味之素(Ajinomoto)創立於1909年。一百多年前,東京帝國大學教授池田菊苗博士發現了谷氨酸鈉(Mono Sodium L-Glutamate),這項發明不僅奠定了味之素的基礎,也被譽為日本十大重要發明之一。
味之素不僅是老牌食品製造商,也擁有環氧樹脂硬化劑開發技術,這項技術成為半導體封裝用層間絕緣材料(ABF)的基礎。1999年,味之素推出半導體封裝用層間絕緣材料「Build-up Film®(ABF)」,成為產業關注的焦點。
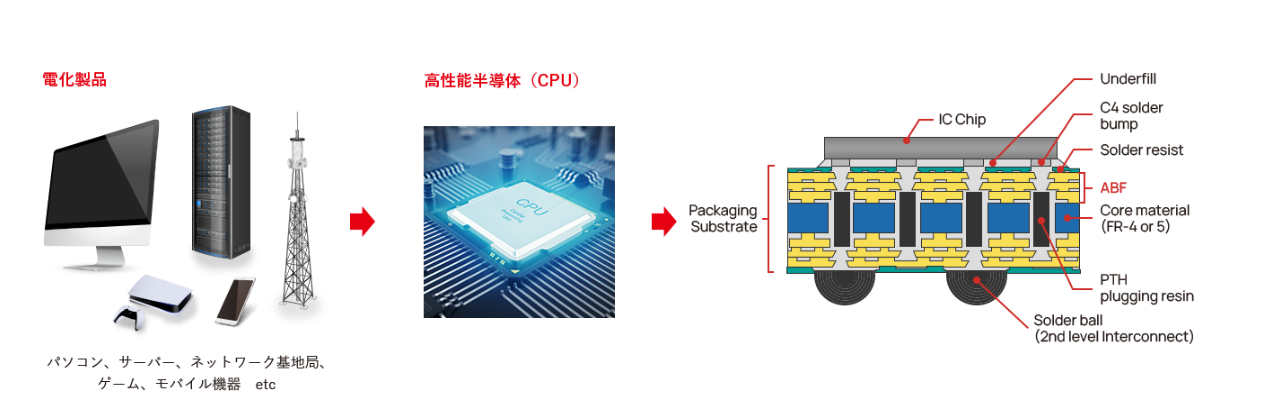
ABF材料的技術突破與製程優勢
在合成法的研發過程中,味之素運用其在氨基酸化學的專長,成功從氨基酸中間體出發,開發出高性能的環氧樹脂硬化劑,進而在1999年誕生了半導體封裝用的層間絕緣材料「Build-up Film®(ABF)」。
在ABF出現之前,半導體封裝基板使用墨水塗布工藝,存在臭味重、氣泡殘留及表面粗糙等缺點,影響電路品質與良率。ABF作為薄膜材料,徹底解決這些問題,使表面平滑度大幅提升,提升電鍍銅線路的精細度。這一技術也是讓智慧型手機、遊戲機、電腦等3C產品,向輕薄小型化邁進的關鍵之一。
ABF材料的製造流程
ABF製作過程包括將樹脂與填料混合成清漆(varnish),塗布於PET基材並乾燥,最後貼合覆蓋膜完成薄膜製品。這種薄膜需符合半導體封裝基板高密度化、輕薄短小的需求,樹脂材料必須具備低粗糙度、低介電常數及低熱膨脹係數,才能確保多層堆疊時的高可靠性與電氣性能。
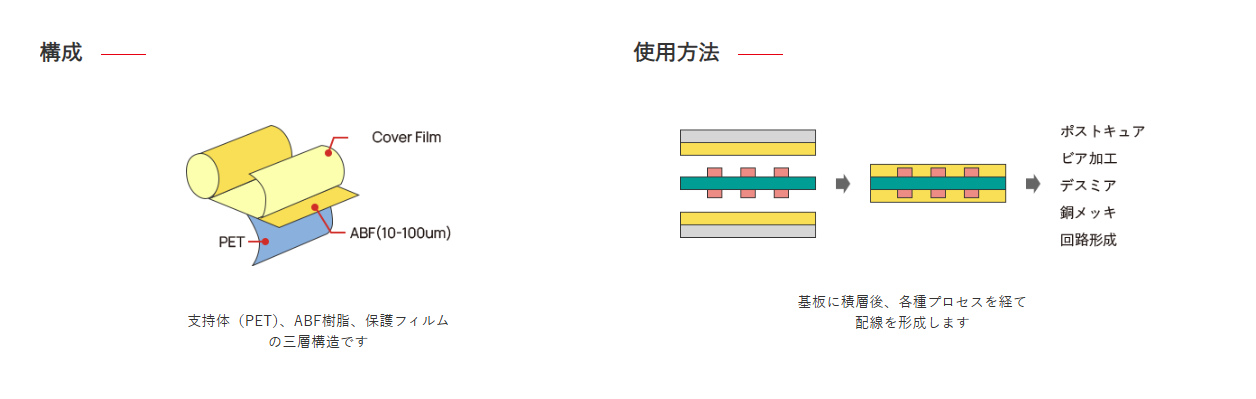
ABF在半導體封裝產業的重要性
隨著半導體封裝基板尺寸變大、速度提升,對絕緣材料的性能要求也日益嚴苛。ABF材料具備高彈性、高絕緣性及優異的製程適合性,有助提升良率並降低成本。ABF材料成為高階封裝基板的關鍵材料,廣泛應用於CPU、GPU及各類高速運算晶片。
圖片來源:Ajinomoto Fine-Techno Co.,Inc.

